고가 '실리콘 인터포저' 대체
내년 시생산…공급망 구축중
메인 기판도 유리 적용 관심

AMD가 2028년 고성능컴퓨팅(HPC)용 반도체에 유리기판을 적용한다. 고가의 미세 회로 기판인 '실리콘 인터포저'를 대체하려는 목적으로, 내년 시생산 라인을 구축할 계획이다. 본격적인 '반도체 유리기판 시장' 개화를 알리는 신호탄일 될 것으로 전망된다.
30일 업계에 따르면, AMD는 2026년 반도체 유리기판 시생산(파일럿), 2028년 제품 적용이라는 기술 로드맵을 수립한 것으로 파악됐다. 반도체 업계에서 차세대 기판으로 꼽히는 유리기판 로드맵이 확인된 건 처음이다.
AMD 사정에 정통한 업계 관계자는 “AMD가 빠르게 반도체 유리기판 소재·부품·장비(소부장) 공급망을 구축하고 현재 샘플 테스트를 진행 중”이라며 “내년 시생산 성과를 확인한 후 대량 생산체제를 갖출 것”이라고 말했다.
AMD는 말레이시아에 반도체 시생산 및 양산 거점을 두려는 것으로 알려졌다. 직접 라인을 구축하지 않고 패키징 협력사를 통해 위탁 생산할 예정이다. 이 패키징 협력사는 현재 국내외 주요 소부장 업계와 라인 조성을 위한 협의를 진행 중이다.
AMD는 반도체 칩 인터포저에 유리기판을 첫 적용할 계획이다. 인터포저는 인공지능(AI) 가속기 등을 패키징할 때 쓰이는 것으로, 중앙에 위치한 그래픽처리장치(GPU)와 주변부에 배치된 고대역폭메모리(HBM)의 연결 통로 역할을 한다.
현재 인터포저는 실리콘 재질을 사용하는데, 가격이 비싸고 공정 시 휨(워피지) 현상 등 난제가 많다. 유리기판은 휨 현상이 실리콘보다 적다. 또 평탄화가 쉽고, 보다 미세한 회로를 구현할 수 있다. 유리기판이 차세대 반도체 기판으로 관심 받는 이유다.
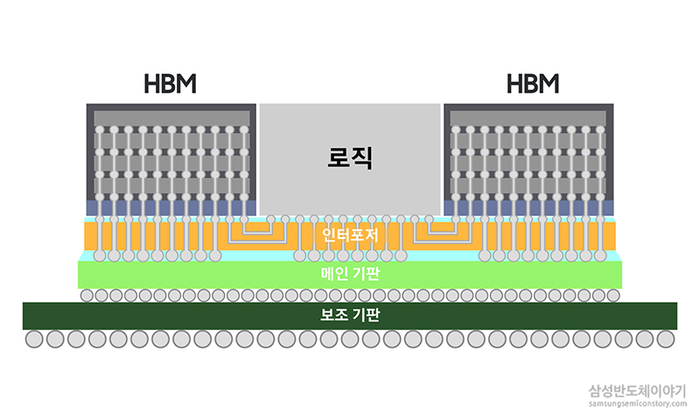
유리기판 적용으로 패키징 공정 변화도 예고됐다. 실리콘 인터포저는 전기 신호를 전달하는 미세 구멍 '실리콘관통전극(TSV)'이 필수다. 유리기판에서는 이를 '유리관통전극(TGV)'으로 바꿔야 한다. TGV는 현재 레이저로 구멍 틀을 만들고, 식각으로 형태를 완성하는 방법이 주류다.
AMD가 앞으로 주(메인) 기판에도 유리를 적용할지도 관심사다. '글래스 코어 기판(Glass Core substrate)'이라 불리는 것으로, 전자기기와 맞붙는 가장 크고 핵심인 기판이다.
업계 관계자는 “다수 반도체 및 빅테크 기업이 반도체 유리기판 샘플 단계에서 여러 테스트를 진행하고 있는 상황”이라며 “AMD가 공급망 구축과 생산 로드맵을 신속히 수립하면서 시장 주도권을 쥐려는 것으로 보인다”고 밝혔다.












